双束聚焦离子显微镜(FIB-SEM)
发布时间:2026-02-11
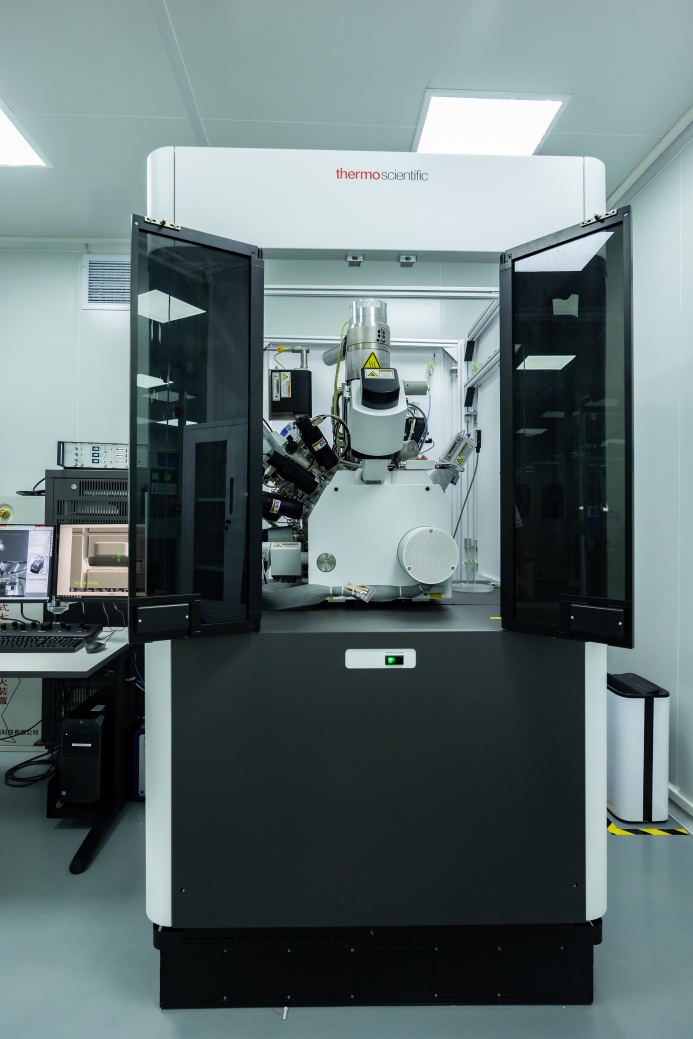
设备名称:聚焦离子束电子束双束显微镜
型号:Helios 5 UX
制造厂家:美国 ThermoFisher 公司
功能用途:
使用Ga离子束进行各类材料的纳微米级尺度高精度加工、修改、成型和高分辨成像。结合电子束高分辨显微表征、能谱和EBSD等辅助分析,进行材料高分辨微观形貌、三维结构、晶体取向及元素含量分析信息测试。利用纳米机械手,可以进行TEM样品的制备。
技术参数:
1. 离子源:Ga离子液态离子源。
2. 离子束交叉点分辨率:2.5 nm@30 kV(选边法),4.5 nm@30 kV (多边法)。
3. 离子束加速电压:0.5 kV ~ 30 kV。
4. 离子束流强度:1.0 pA ~ 65 nA。
5. X、Y 方向移动范围 150 mm;Z 范围 10 mm;倾斜范围-10 度至 60 度;可绕 Z 轴旋转任意角度(360 度)
案例分享:
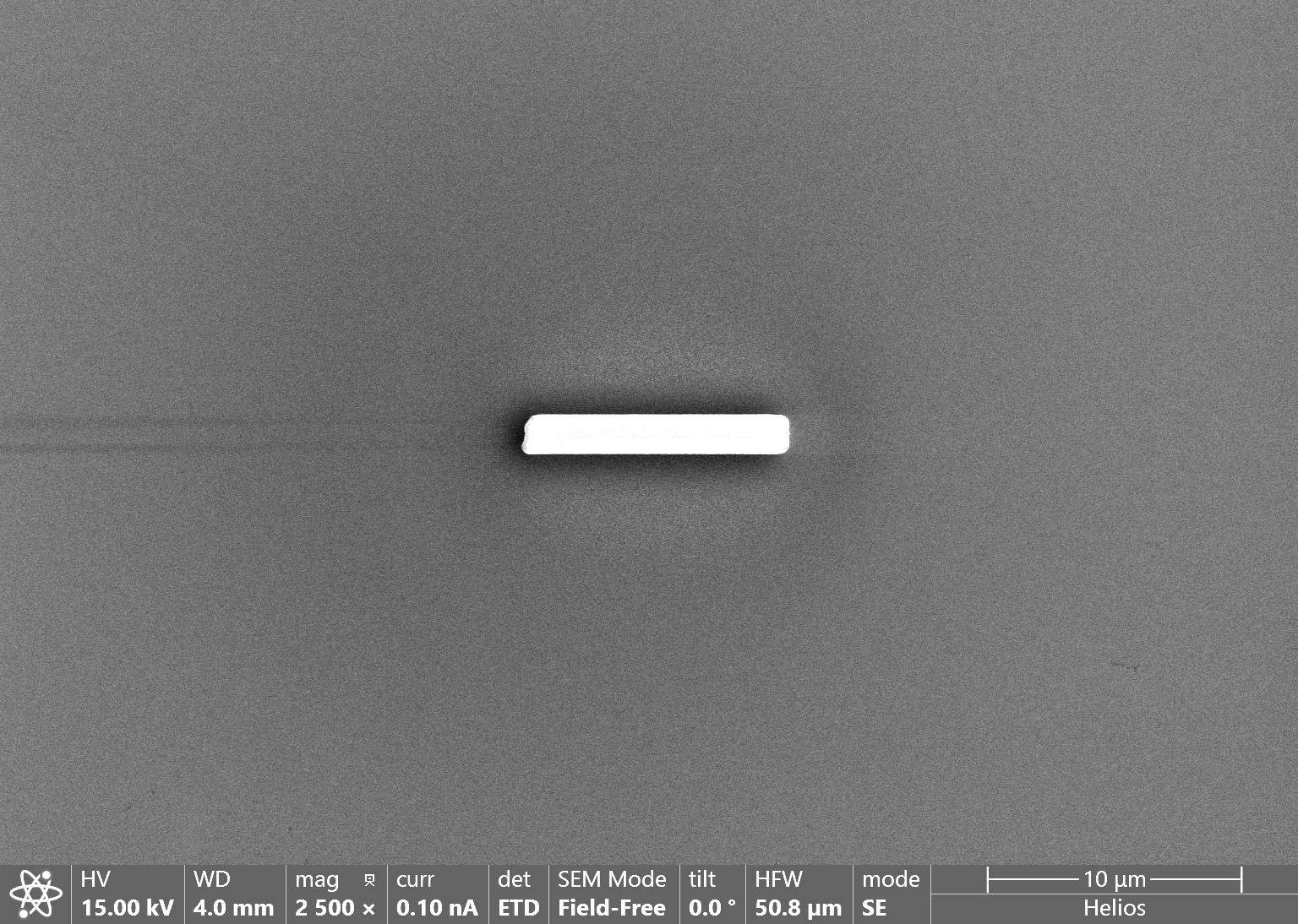
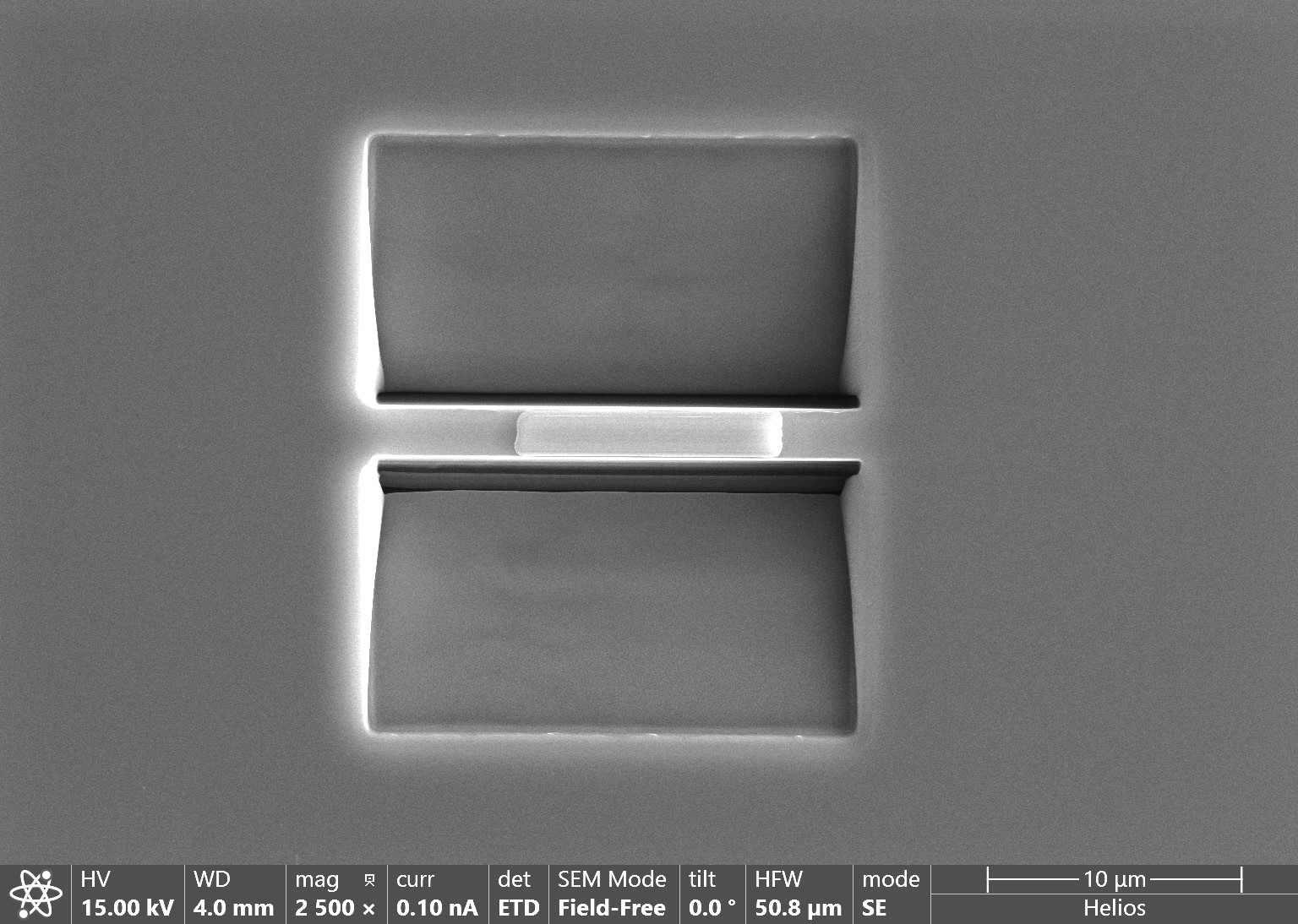
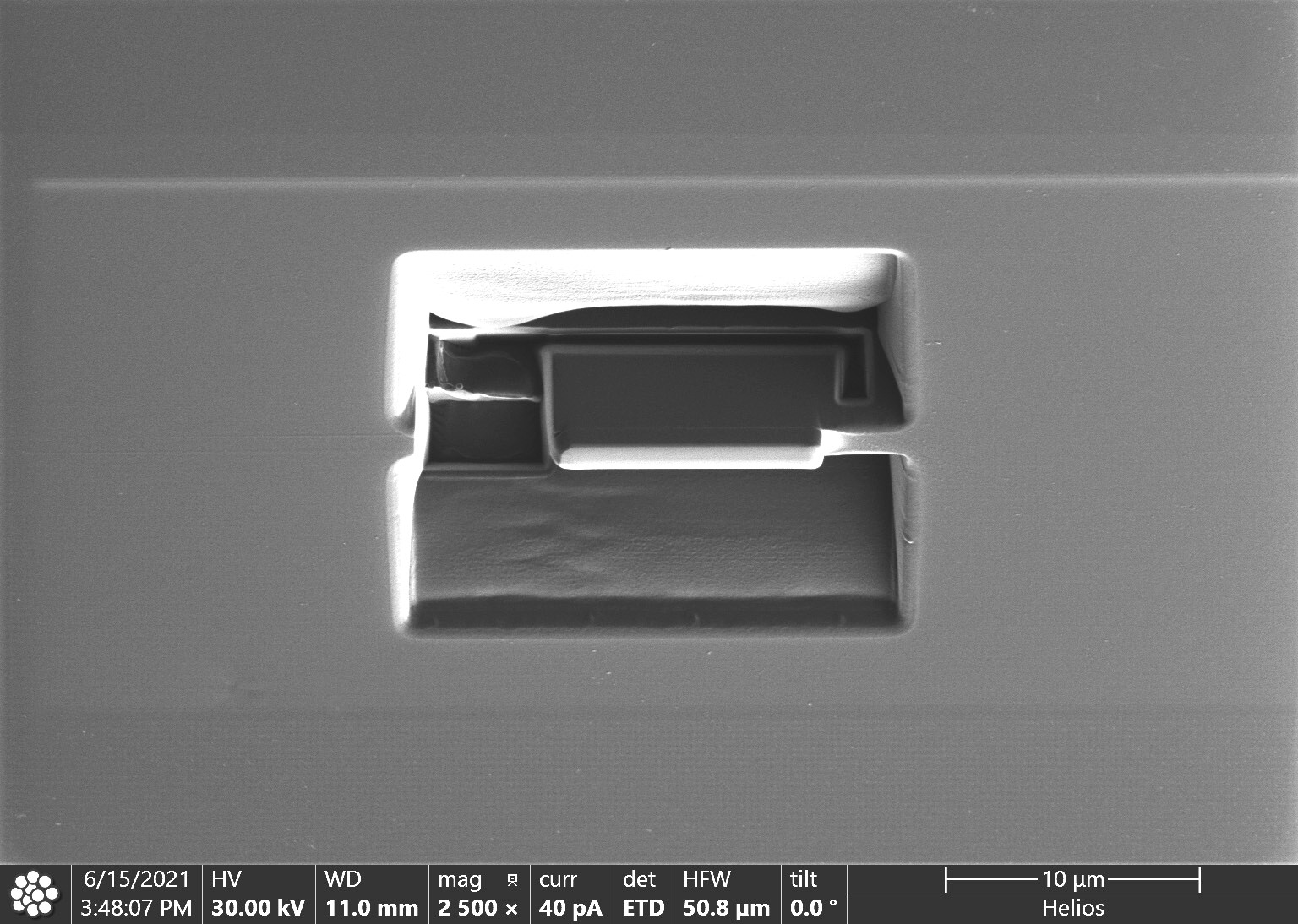
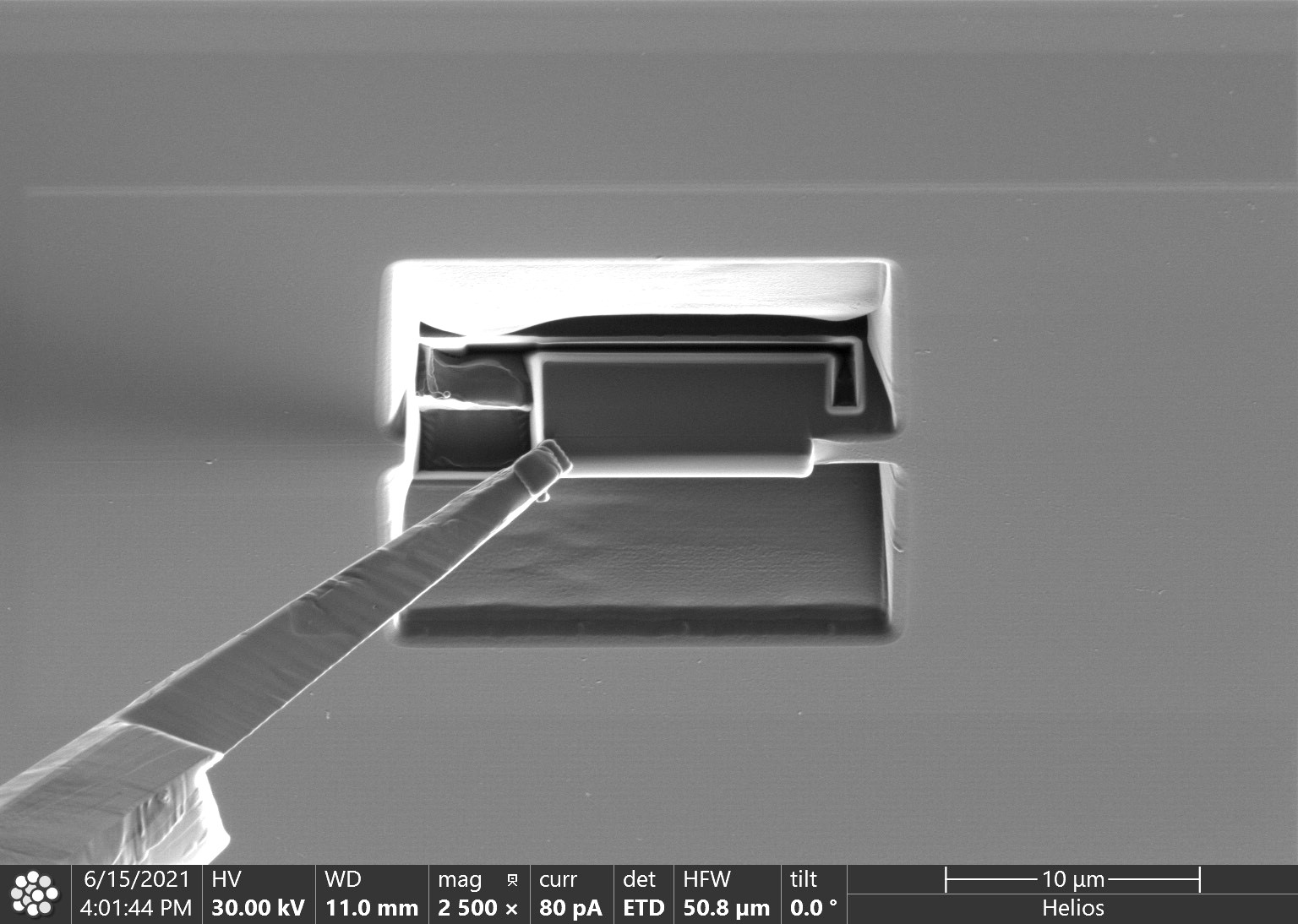
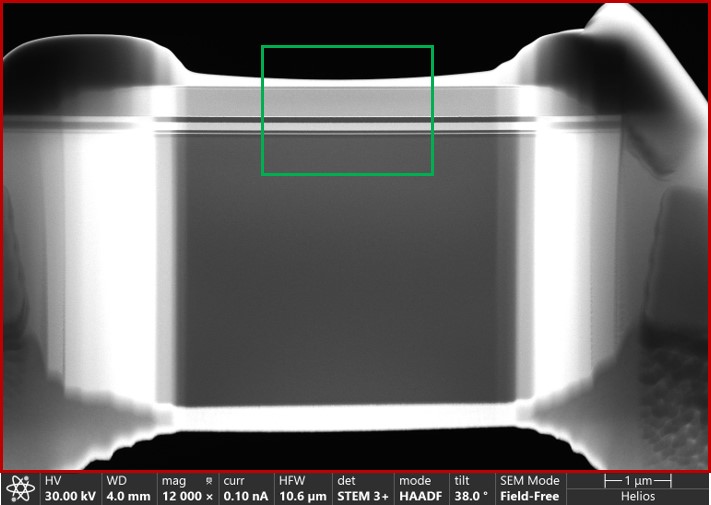
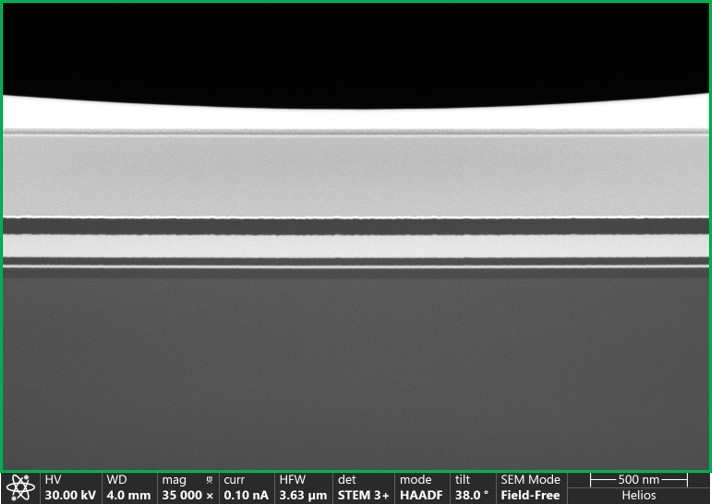

 服务热线:400-029-9908
服务热线:400-029-9908





