【干货】电子元器件失效机理总结,建议收藏!
发布时间:2024-03-13
根据博仕检测解决的电子元器件失效分析案子,总结电子元器件失效机理如下:
1.过应力失效
·电过应力——电源输出输入的电源、电压超过规定的最大额定值。
·热过应力——环境温度、壳温、结温超过规定的最大额定值。
·机械过应力——振动、冲击、离心力或其他力学量超过规定的最大额定值。
2.CMOS电路闩锁失效
·条件——在使用上(Vl; VO) >VDD或 (Vl;VO)<VSS;或电源端到地发生二次击穿。
·危害——一旦导通电源端产生很大电流,破坏性和非破坏性。
·失效特点——点现象,内部失效判别。
3.ESD失效机理
静电放电给电子元器件带来损伤,引起的产品失效。
·过电压场致失效——放电回路阻抗较高,元器件因接受高电荷而产生高电压导致电场损伤,多发生于电容器件。
·过电流热致失效——放电回路阻抗较低,元器件因放电期间产生强电流脉冲导致高温损伤,多发生于双极器件。

4.金属腐蚀失效
·当金属与周围介质接触时,由于发生化学反应或电化学作用而引起金属腐蚀。
·电子元器件中,外引线及封装壳内的金属因腐蚀而引起电性能恶化直至失效。
·腐蚀产物形貌观察和成分测定对失效分析很有帮助。
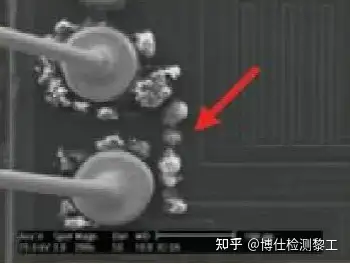
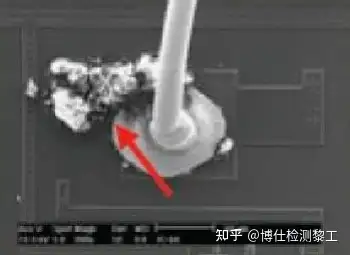
5.银离子迁移
·银离子迁移是一种电化学现象,在具备水份和电场的条件时发生。
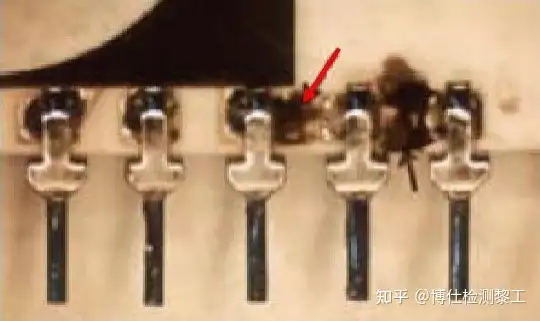
6.金铝化合物失效
·金和铝键合,在长期储存和使用后,金铝之间生成AuAl2,AuAl,Au2Al,Au5Al2,Au4AI等金属间化合物(IMC)。
·这些IMC的物理性质不同,电导率较低。AuAl2呈紫色,俗称紫斑;Au5Al2,Au4AI呈浅金黄色,俗称黄斑;Au2Al呈白色,俗称白斑。
·键合点生成金铝化合物后,键合强度降低、变脆开裂、接触电阻增大,器件出现性能退化或引线从键合界面处脱落导致开路。
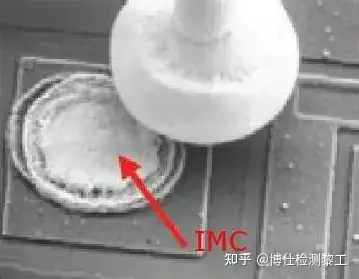

7.柯肯德尔效应
·金铝键合系统中,若采用Au丝热压焊工艺,由于高温,金向铝中迅速扩散,在金层一侧留下部分原子空隙,这些原子空隙自发聚积,在金属间化合物与金属交界面上形成了空洞,这称为柯肯德尔效应。
·当柯氏效应(空洞)增大到一定程度后,将使键合界面强度急剧下降,接触电阻增大,最终导致开路失效。
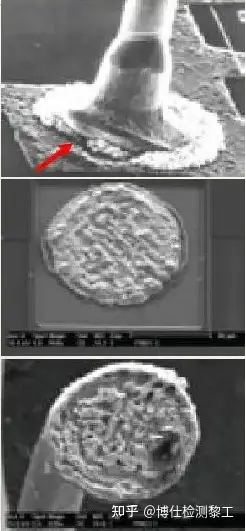
8.金属化电迁移
·在外电场作用下,导电电子和金属离子间相互碰撞发生动量交换而使金属离子受到与电子流方向一致的作用力,金属离子由负极向正极移动,这种作用力称为“电子风”。
·对铝、金等金属膜,电场力很小,金属离子主要受电子风的影响,使金属离子朝正极移动,在正极端形成金属离子的堆积形成小丘,而在负极端生产空洞,使金属条断开。

9.“爆米花效应”(分层效应)
“爆米花效应”是指塑封器件塑封材料内的水份在高温下受热发生膨胀,使塑封料与金属框架和芯片间发生分层,拉断键合丝,发生开路失效或间歇失效。
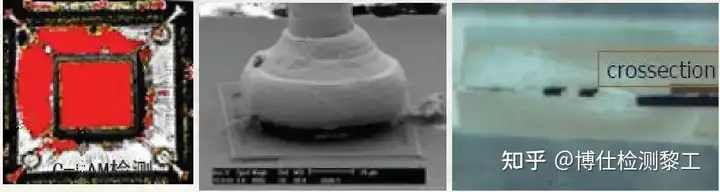


 服务热线:18122487888
服务热线:18122487888



