双束聚焦离子显微镜FIB-SEM测试分析
发布时间:2024-02-23
近期不少客户朋友咨询博仕检测工程师,关于FIB切片分析的制样品的问题,这篇文章分享给大家,希望能帮到大家。
聚焦离子束技术(Focused Ion eam,FIB)是利用电透镜将离子束聚焦成非常小尺寸的离子束轰击材料表面,实现材料的剥离、沉积、注入、切割和改性。随着纳米科技的发展,纳米尺度制造业发展迅速,而纳米加工就是纳米制造业的核心部分,纳米加工的代表性方法就是聚焦离子束。近年来发展起来的聚焦离子束技术(FIB)利用高强度聚焦离子束对材料进行纳米加工,配合扫描电镜(SEM)等高倍数电子显微镜实时观察,成为了纳米级分析、制造的主要方法。目前已广泛应用于半导体集成电路修改、离子注入、切割和故障分析等。
聚焦离子束技术(FIB)原理:
聚焦离子束(FIB)系统利用镓离子源和双透镜聚焦柱,用强烈的聚焦离子束轰击标本表面,以进行精密材料去除、沉积和高分辨率成像。简单来说是聚合了FIB处理样品和SEM观察成相的功能。其中FIB是将Ga元素离子化成Ga+,然后利用电场加速,再利用静电透镜聚焦将高能量的Ga+打到指定点从而达到处理样品的功能。
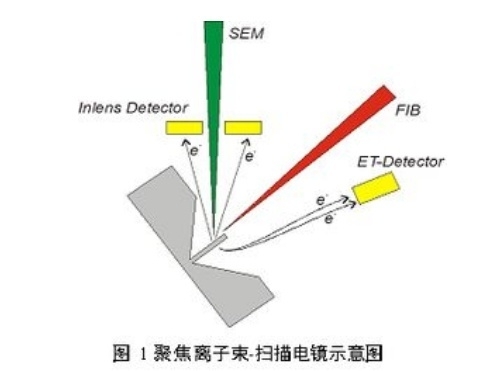
FIB-SEM切片测试过程
服务领域:光电材料,半导体材料,镀膜材料, 金属材料,矿石,纳米材料,高分子材料,锂电材料,数据存储,生物材料,通讯行业等。
聚焦离子束-扫描电子显微镜双束系统 FIB-SEM应用
聚焦离子束-扫描电镜双束系统主要用于表面二次电子形貌观察、能谱面扫描、样品截面观察、微小样品标记以及TEM超薄片样品的制备。
1.FIB切片截面分析 FIB-SEM测试
FIB技术可以精确地在器件的特定微区进行截面观测,形成高分辨的清晰图像,并且对所加工的材料没有限制,同时可以边刻蚀边利用SEM实时观察样品,截面分析是FIB最常见的应用。这种刻蚀断面定位精度极高,在整个制样过程中样品所受应力很小,制作的断面因此也具有很好的完整性。这种应用在微电子领域具体运用场合主要有:定点观测芯片的内部结构;失效样品分析烧毁的具体位置并定位至外延层;分析光发射定位热点的截面结构缺陷。
FIB切片截面分析过程:
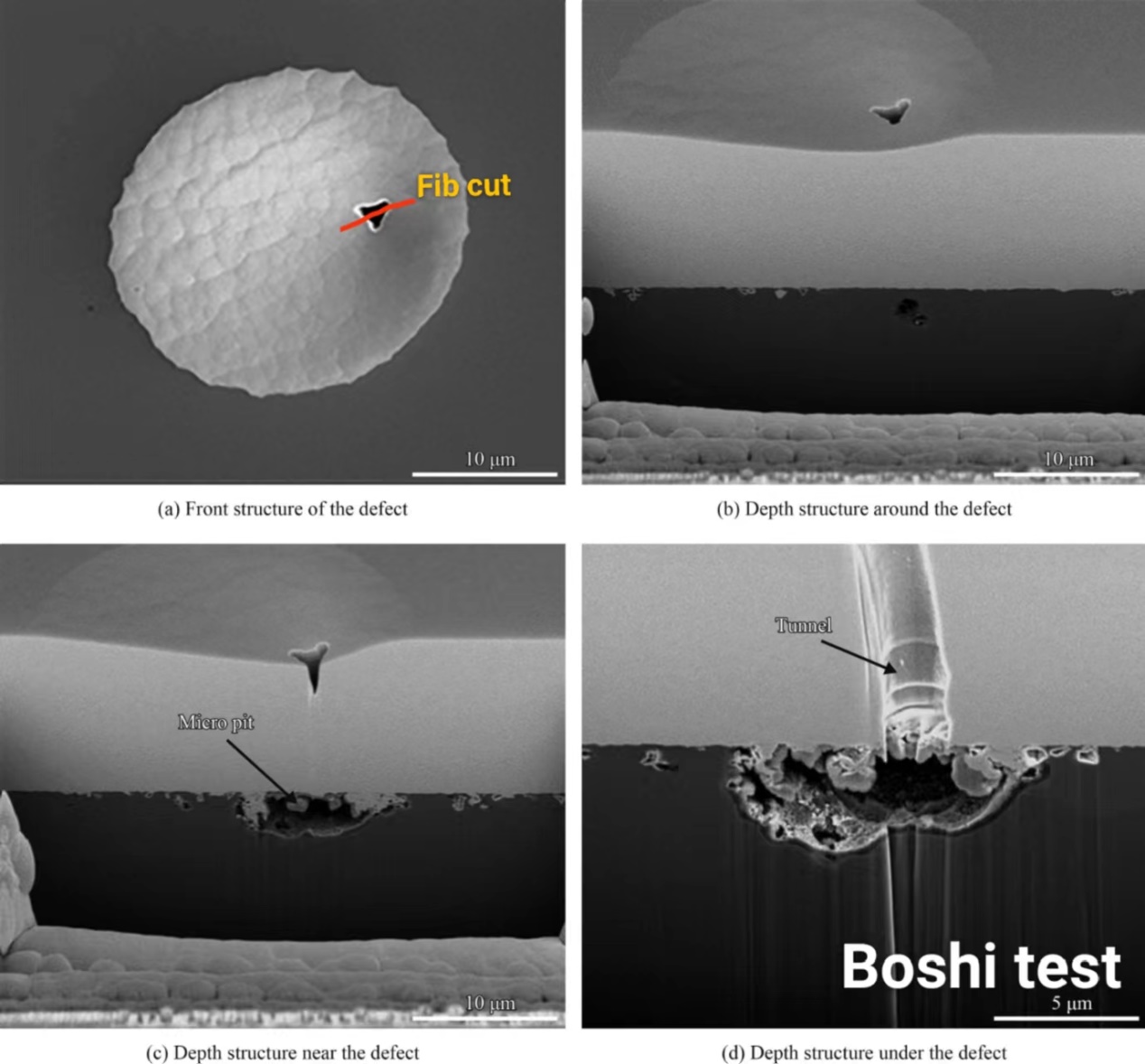
FIB切片截面分析过程
FIB制备TEM样品过程:
1. Platinum deposition:用电子束或离子束辅助沉积的方法在待制备TEM试样的表面蒸镀Pt保护覆层,以避免最终的TEM试样受到Ga离子束导致的辐照损伤;
2. Bulk-out:在带制备的TEM试样两侧用较大的例子束流快速挖取“V”型凹坑;
3. U-cut:在步骤(2)中切取出的TEM薄片上切除薄片的两端和底部;
4. Lift-out:用显微操控针将TEM试样从块状基体移出,试样与针之间用蒸镀Pt方式粘结;
5. Mount on Cu half-grid:用显微操控针将移出的TEM薄片转移并粘接在预先准备好的TEM支架上;
6. Final milling:用较小利息束流对TEM薄片进一步减薄,直至厚度约约100 nm。
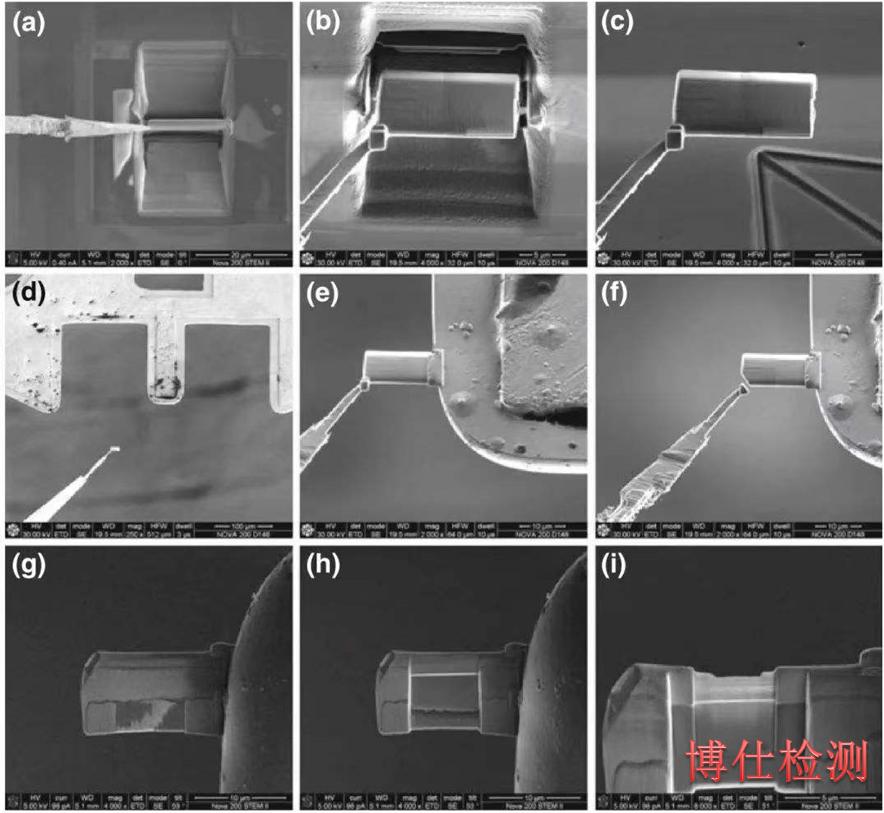
FIB制备TEM薄片过程
博仕检测FIB-SEM检测实例分享:
(1)电镀品截面镀层结构分析 :
客户委托博仕检测对客诉异常电镀产品FIB-SEM分析,FIB切割电镀品内部结构图及SEM背散射(BSE)图

FIB切片SEM观察镀层内部结构图
d. SEM BSE低倍整体图片; e.SEM BSE缺陷局部放大图; f.SEM BSE缺陷局部放大图 备注:对晶粒尺寸观察的分辨率最小可达30nm。
(2)微米级缺陷样品FIB-SEM截面测试
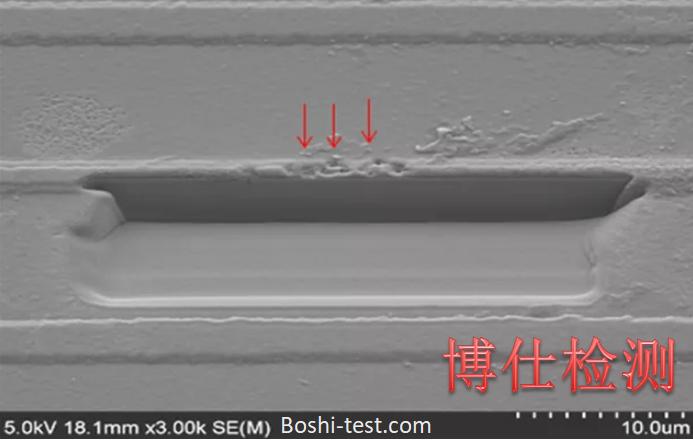
(3)PCB电路断裂位置,利用SEM观察铜箔金相。

FIB切割PCB电路截面分析
(4)FIB切割锡球截面分析

FIB切割锡球截面分析
(5)FIB切割晶粒分析

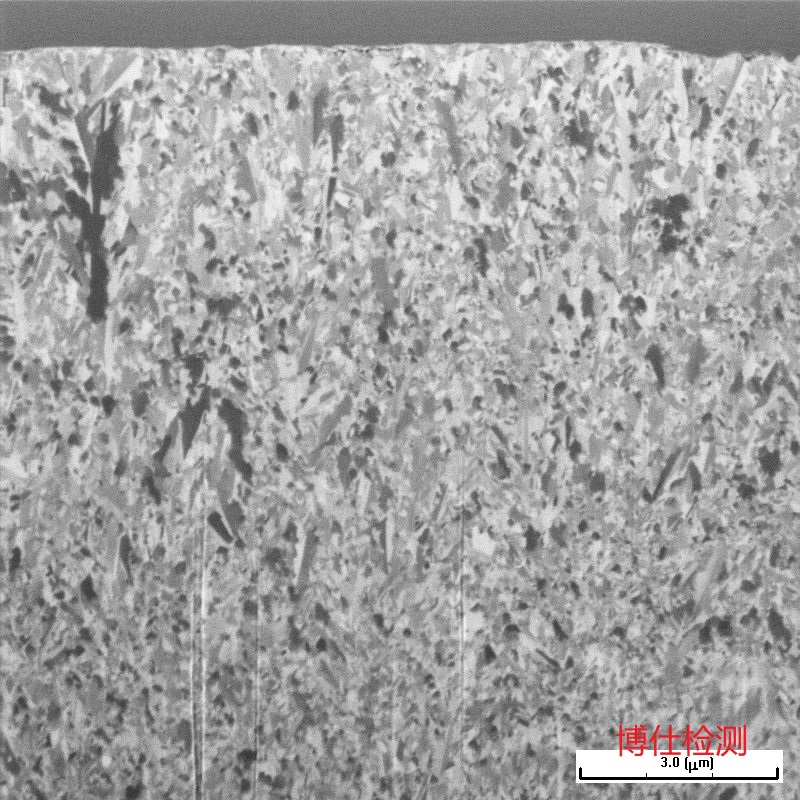

 服务热线:18122487888
服务热线:18122487888



