飞行时间二次离子质谱仪 TOF SIMS
发布时间:2023-12-01
飞行时间二次离子质谱(TOF-SIMS),也叫静态二次离子质谱,是飞行时间和二次离子质谱结合的一种新的表面分析技术。TOF-SIMS具有高分辨、高灵敏度、精确质量测定等性能,是目前高技术领域广泛使用的分析技术。
此外,TOF-SIMS是非常灵敏的表面分析手段。其凭借质谱分析、二维成像分析、深度元素分析等功能,广泛应用于医学、细胞学、地质矿物学、半导体、微电子、物理学、材料化学、纳米科学、矿物学、生命科学等领域。
一、基本原理
飞行时间-二次离子质谱仪(Time of Flight Secondary Ion Mass Spectrometry,简称TOF-SIMS)是一种基于质谱的表面分析技术。其原理是基于一次离子与样品表面相互作用(如下图)。高能一次离子束(如Ga+,Bi3+, Arn+,Cs+等)轰击样品表面,在轰击区域产生包含样品表面成分信息的带电粒子即离子,这些带电离子经过质量分析后得到表面成分信息的质谱,简称二次离子质谱。
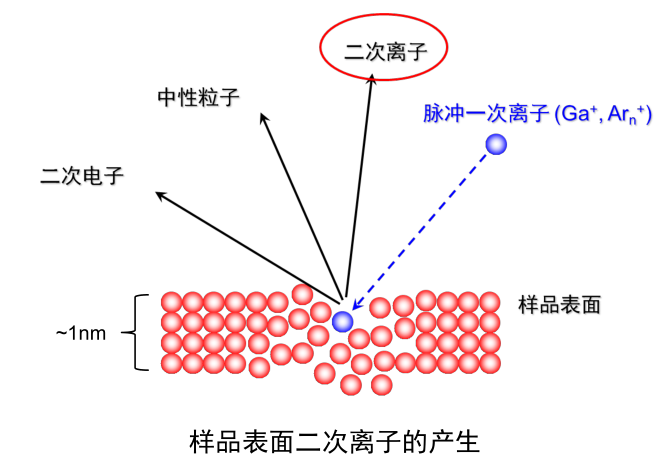
二次离子质谱主要利用质谱法区分一次离子溅射样品表面后产生的二次离子,可用来分析样品表面元素成分和分布[2]。
飞行时间分析技术利用不同离子的质荷比不同造成的飞行速度不同来区分不同种类的离子。
TOF-SIMS结合了二次离子质谱和飞行时间器的功能,提高了检测样品元素成分和分布的准确性。
TOF-SIMS横向和纵向的分辨率高且质谱提供的灵敏度高,可以分析元素、同位素、分子等信息。
这些特点使得TOF-SIMS成为表面分析的主要技术之一,可以提供EDX、AES、XPS等技术无法提供的元素信息。
二、TOF-SIMS的特点
TOF-SIMS具有二次离子质谱和飞行时间分析技术的特点。
(1)高达ppm/ppb量级的检测灵敏度;
(2)深度剖析功能;
(3)可以检测H元素在内的元素和同位素;
(4)结合标准样品,可以进行定量分析;
(5)高横向分辨率(< 60 nm);
(6)深度分辨率优于1 nm;
(7)高精度扫描(像素分辨率高达1024 × 1024);
(8)快速检测,快速图像采集(像素频率高达50 Hz);
(9)溅射速度可达10 μm/h;
(10)图像采集区域范围可从μm2到cm2量级;
(11)样品消耗少;
(12)可进行原子、基团、碎片和分子的检测[3];
(13)高质量范围、高质量分辨率。
三、样品要求
(1)样品尺寸尽可能小:长/宽最好不超过1cm,厚度不超过5mm;
(2)测试样品不受导电性的影响,绝缘样品也可以测试;
(3)粉末样品至少需要10 mg;
(4)测试面和对应面平行,样品平整度:测试面尽量平整;
(5)测试面可以为规则形状也可以为不规则形状。
(6)样品保存条件:需测试样品表面成分的,请不要对样品进行擦拭、触摸等,避免污染测试面。
(7)样品包装条件:样品用干净材料包装,尽量避免接触测试面,存放于温湿度适宜条件下。有条件可
以真空包装保存。
四、应用
飞行时间二次离子质谱主要通过质谱分析、表面成像(二维成像/三维成像)、深度剖析等功能,从而分析样品表面元素成分和分布。
1. 表面质谱
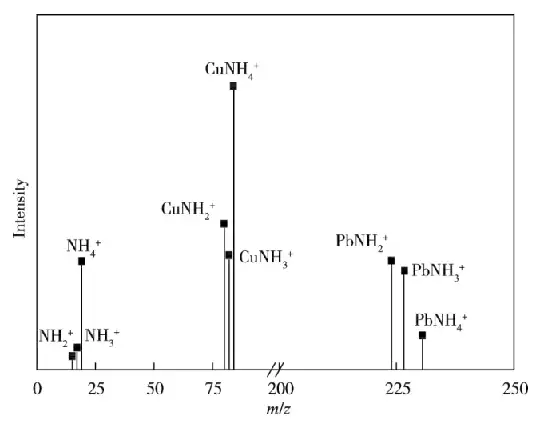
2. 表面成像分析
a. 表面化学成分的成像分布
b. 元素、同位素、分子的二维成像分布
c.空间分辨率高达80nm
d. 各成分分布图可平行获取
3.深度剖析
在飞行时间二次离子质谱中,对样品施加低能量的离子束, 这个离子束会对样品进行刻蚀从而形成一个微小的溅射凹坑,同时采用脉冲式离子束对溅射凹坑中心进行分析,这便是深度分析。
深度分析采用的是双束离子分析:溅射源离子和分析源离子。通过深度分析,研究者可以得到样品随深度变化的离子强度分布。
深度分析可以达到优于1 nm的分辨率,深度溅射速度可以达到10 μm/h。

案例:金属-半导体材料内部各元素的深度分布
实验对未退火和退火处理后的芯片进行深度分析,作者重点关注了Au、O、Be、P、Ga元素的深度分布。实验结果如下图6所示。
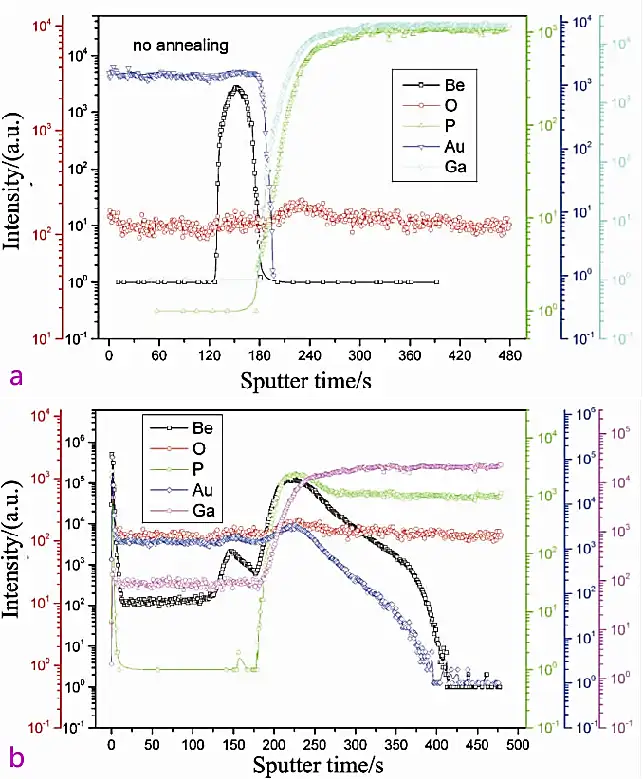
由图6可得,没有经过退火处理的芯片在金属半导体界面内,各元素没有明显的相互扩散现象,氧元素强度基本稳定。退火处理后的芯片有着明显的元素扩散现象。
4.3D分析
通过综合质谱、二维成像、深度分析的数据,可以实现样品成分的三维成像,得到3D图。通过3D图可以分析样品结构、缺陷等信息。如图7所示,为一个未知样品的3D示意图。


 服务热线:18122487888
服务热线:18122487888



